当前位置 :首页>新闻动态
近日,南方科技大学工学院国家示范性微电子学院于洪宇院长团队在宽禁带半导体材料和器件领域取得重要进展,特色研究成果包括免刻蚀常关型GaN凹栅MIS-HEMT器件、具有长期工作可靠性的p-GaN HEMT器件及新型栅极击穿测量方法、实现低磁滞和高稳定性的HfO2/GaN MIS-HEMT器件、精确控制InAlN/GaN异质结构刻蚀深度和表面形貌的新型原子层刻蚀技术,以及高性能Ga2O3功率二极管制备。相关论文成果分别发表于国际微电子器件顶级期刊IEEE Electron Device Letters、IEEE Transactions on Electron Devices、Journal of Vacuum Science and Technology B以及Materials Science in Semiconductor Processing。
免刻蚀常关型GaN凹栅MIS-HEMT器件
GaN作为新一代半导体材料,相较于传统硅、锗材料,在禁带宽度、击穿电场、饱和速度、热导率等方面具有明显的优势,在智能电网、电动汽车驱动、开关电源、5G通讯和雷达等高频高功率领域具有广阔的应用前景。基于高功率电源电路对常关型GaN器件的需求,于院长团队开发了两种新型的选择性区域再生长技术,结合高质量原位SiNx钝化及原子层沉积工艺,制备了一系列高性能的免刻蚀常关型GaN凹栅MIS-HEMT器件。该工作有效抑制了二次外延和原位SiNx工艺制备常关型GaN HEMT的技术缺陷,实现了超低的导通电阻及阈值电压迟滞,为开发低损伤常关型GaN功率器件提供了翔实的理论指导和技术支持。
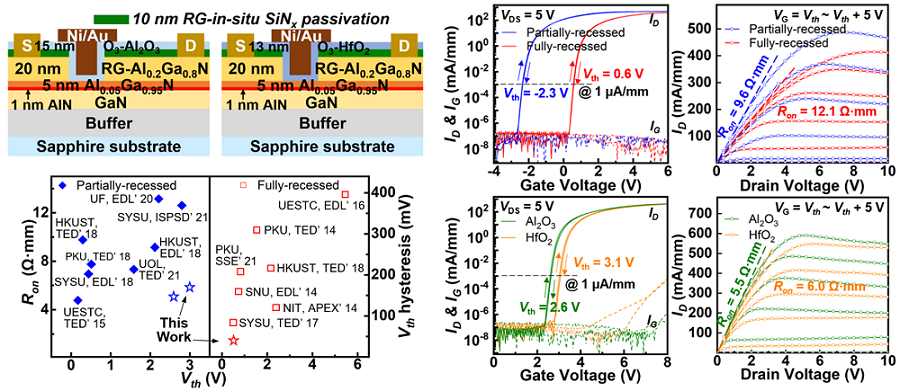
论文[1]中GaN凹栅MIS-HEMT器件结构及电学表征结果
相关成果以“Normally-OFF AlGaN/GaN MIS-HEMTs with Low RON and Vth Hysteresis by Functioning In-situ SiNx in Regrowth Process”[1]为题发表于IEEE Electron Device Letters上(IF:4.187),南科大微电子学院博士研究生何佳琦为本论文第一作者,本工作得到了广东省科学技术厅和深圳科技创新委员会的项目支持。
[1] J. He, Q. Wang, G. Zhou, W. Li, Y. Jiang, Z. Qiao, C. Tang, G. Li*, and H. Yu*, "Normally-OFF AlGaN/GaN MIS-HEMTs with Low RON and Vth Hysteresis by Functioning In-situ SiNx in Regrowth Process", IEEE Electron Device Letters, vol. 43, no. 4, pp. 529-532, 2022
论文DOI:10.1109/LED.2022.3149943
具有长期工作可靠性的p-GaN HEMT器件及新型栅极击穿测量方法
目前高功率电源电路中的开关管通常采用p-GaN型栅常关型HEMT器件,但这种已经实现商业化生产的器件结构仍存在一定问题:由于结构上与高k栅介质不兼容,其栅极击穿电压通常较低;在较高的栅极驱动电压条件下,其长期工作可靠性不足,器件容易损坏。栅极击穿电压及其可靠性作为功率开关器件的核心性能,在工业生产及实际应用中具有重要研究价值。于院长团队通过调控p-GaN在外延生长过程中的参数,有效降低了栅金属/p-GaN肖特基结的尖峰电场,制备出在10.6 V栅极驱动电压下具有10年工作可靠性的常关型HEMT器件。基于对p-GaN HEMT器件栅极击穿特性的研究,提出了一种新型的栅极击穿测量方式,能够将p-GaN器件的肖特基势垒击穿、PN结击穿及钝化层击穿特性独立表征,为研究p-GaN器件可靠性提供了一条新的思路。
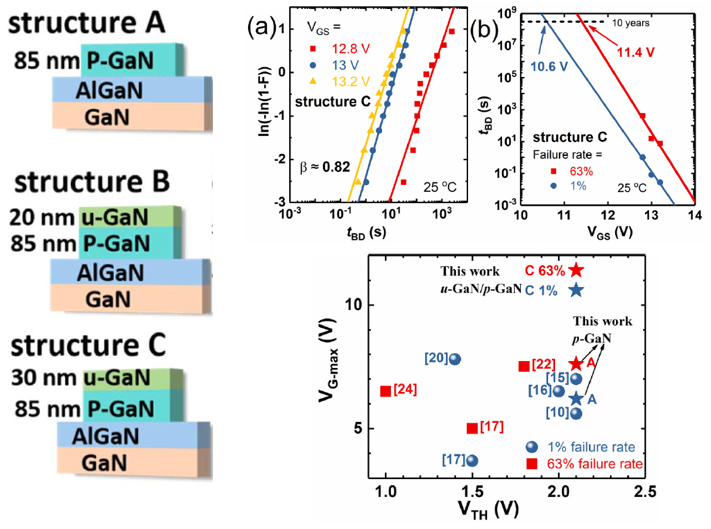
论文[2]中p-GaN HEMT器件结构及长期可靠性表征结果

论文[3]中p-GaN HEMT器件不同击穿机制表征结果
相关成果以“p-GaN Gate HEMTs With 10.6 V Maximum Gate Drive Voltages by Mg Doping Engineering”[2]和“Determination of the Gate Breakdown Mechanisms in p-GaN Gate HEMTs by Multiple-Gate-Sweep Measurements” [3]为题发表于IEEE Transactions on Electron Devices上(IF:2.917),南科大微电子学院博士研究生周广楠为两篇论文的第一作者,本工作得到了广东省科学技术厅和深圳科技创新委员会的项目支持。
[2] G. Zhou, F. Zeng, R. Gao, Q. Wang, K. Cheng, L. Li, P. Xiang, F. Du, G. Xia*, and H. Yu*, "p-GaN Gate HEMTs With 10.6 V Maximum Gate Drive Voltages by Mg Doping Engineering", IEEE Transactions on Electron Devices, Mar. 2022.
论文DOI:10.1109/TED.2022.3157569
[3] G. Zhou, F. Zeng, Y. Jiang, Q. Wang, L. Jiang, G. Xia*, H. Yu*, "Determination of the Gate Breakdown Mechanisms in p-GaN Gate HEMTs by Multiple-Gate-Sweep Measurements", IEEE Transactions on Electron Devices, 68, 4 (2021)
论文DOI:10.1109/TED.2021.3057007
低磁滞和高稳定性的HfO2/GaN MIS-HEMT器件
在半导体器件中,高k材料作为栅极介质,可以有效抑制栅漏电、提升栅控能力。对于GaN来说,高k材料氧化铪(HfO2)具有高击穿场强和栅介质电容,并且和GaN具有足够的能带偏移,使其较之其它GaN MIS-HEMT常用栅介质(如Al2O3、SiO2和SiNx等)来说,有巨大的应用潜力。然而,目前常用的原子层沉积技术(ALD)制备的HfO2/GaN界面,具有高缺陷密度的缺点,成为了HfO2在GaN器件应用上的阻碍。于院长团队对HfO2的沉积条件进行摸索,通过臭氧预处理,大大降低了HfO2/GaN的缺陷密度,测试结果表明,器件具有低磁滞、低器件关态漏电和高开关比的特性,实现了高性能、高可靠性的GaN MIS-HEMT器件。

论文[4]中通过臭氧预处理的HfO2/GaN界面TEM横截面图和电学量测表征结果
相关成果以“Low trap density of oxygen-rich HfO2/GaN interface for GaN MIS-HEMT applications”[4]为题发表于Journal of Vacuum Science and Technology B上(IF:1.416),南科大微电子学院博士研究生郑韦志为本文的第一作者,本工作得到了广东省科学技术厅和深圳科技创新委员会的项目支持。
[4] W.-C. Cheng, J. He, M. He, Z. Qiao, Y. Jiang, F. Du, X. Wang, H. Hong, Q. Wang*, and H. Yu*, "Low trap density of oxygen-rich HfO2/GaN interface for GaN MIS-HEMT applications," Journal of Vacuum Science & Technology B, vol. 40, no. 2, p. 022212, 2022/03/01 2022
论文doi: 10.1116/6.0001654.
InAlN/GaN异质结构刻蚀深度和表面形貌高精度可控的新型原子层刻蚀技术
In0.17Al0.83N/GaN异质结具有无应力和强自发极化的特性,相关器件具有高可靠性、超高输出电流密度和有效抑制短沟道效应的特点,在GaN基射频和功率器件中具有较大的潜力,在卫星通信、无线基础设施、消费电子、数据中心电力系统等方向具有很好的应用前景。其中,刻蚀技术在高性能InAlN/GaN基器件的制备中起到了重要的作用,于院长团队通过研究O2/BCl3原子层刻蚀(ALE)技术在InAlN/GaN异质结构的应用,并结合AlN插入层,首次提出具有自停止效应的、刻蚀深度可控的超低损伤InAlN ALE技术,揭示了ALE刻蚀机理和自停止效应机理,使更高性能InAlN/GaN基器件的设计和制备成为可能。
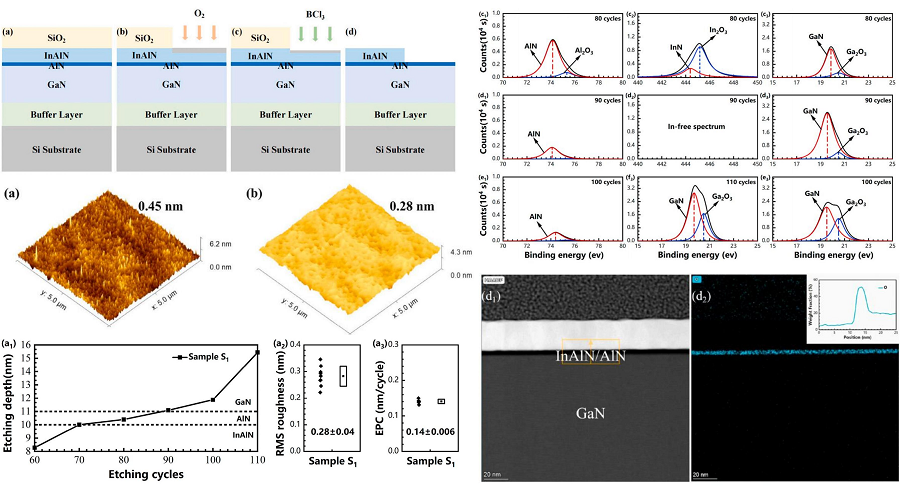
论文[5]中InAlN/GaN异质结构ALE工艺流程图,刻蚀后表面形貌对比,刻蚀深度曲线,基于XPS和TEM/EDX的相关机理研究结果
相关成果以“Atomic layer etching technique for InAlN/GaN heterostructure with AlN etch-stop layer” [5]为题发表于Materials Science in Semiconductor Processing上(IF:3.927),南科大微电子学院本科生杜方洲和深港微电子学院访问学生蒋洋为本文共同第一作者,本工作得到了广东省科学技术厅和深圳科技创新委员会的项目支持。
[5] F. Du#, Y. Jiang#, Z. Qiao, Z. Wu, C. Tang, J. He, G. Zhou, W. C. Cheng, X. Tang, Q. Wang*, H. Yu*, "Atomic layer etching technique for InAlN/GaN heterostructure with AlN etch-stop layer", Materials Science in Semiconductor Processing, 143, 106544 (2022).
论文DOI:10.1016/j.mssp.2022.106544
高性能Ga2O3功率二极管制备方法
随着对新能源汽车、高铁以及一些极端环境下应用的需求增加,对应相关领域电力系统的高压高功率、抗辐射耐高温的高性能半导体电子器件越来越受到关注。氧化镓(β-Ga2O3)具有超宽禁带宽度(~4.9 eV)、高击穿电场(~8 MV/cm)、高的热稳定性和化学稳定性等特点,并且可以通过经济高效的熔体法制备技术进行单晶生长,具有大规模低成本制造的潜力,被认为是未来支撑能源、信息、交通、制造、国防等领域快速发展的新一代半导体材料。其中,二极整流管是体现Ga2O3优势的一个重要应用,于院长团队通过在Ga2O3二极管的肖特基界面插入一层铝反应层,提升了器件金属半导体界面的质量,取得了超低的亚阈值摆幅,降低了漏电,改善了器件的均一性和良率。
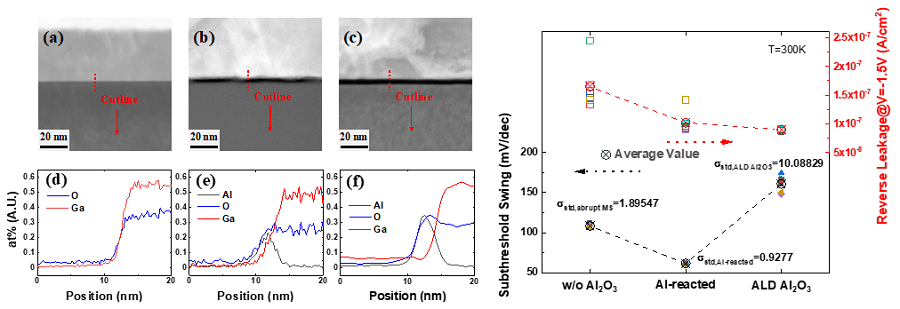
论文[6]中Ga2O3功率二极管界面TEM图、EDS元素分析及其电学测试结果
相关成果以“Improvement of β-Ga2O3 MIS-SBD Interface Using Al-Reacted Interfacial Layer” [6]为题发表于IEEE Transactions on Electron Devices上(IF:2.917),南科大微电子学院博士研究生何明浩为第一作者,本工作得到了广东省科学技术厅和深圳科技创新委员会的项目支持。
[6] M. He, W. C. Cheng, F. Zeng, Z. Qiao, Y. C. Chien, Y. Jiang, W. Li, L. Jiang, Q. Wang, K. W. Ang*, H. Yu*, "Improvement of β-Ga2O3 MIS-SBD Interface Using Al-Reacted Interfacial Layer", IEEE Transactions on Electron Devices, 68, 7 (2021).
论文DOI:10.1109/TED.2021.3081075
于洪宇教授课题组欢迎优秀的本科生、研究生和博士后加入。