当前位置 :首页>新闻动态
集成电路制造工艺越来越接近硅基晶体管的物理极限,而且现代社会对计算硬件的算力、速度、能耗等提出了更高的要求,“冯·诺依曼架构”的“存储墙”问题严重限制了算力的提升。基于氧化物半导体忆阻器的存内计算系统,具有制备温度低(< 400 ℃)、速度快、功耗低和可3D集成等优势,有望成为新一代推动集成电路发展的重要计算硬件。1T1R(一个晶体管,一个电阻器)是忆阻器阵列最常用的技术之一,可以有效限制存储单元之间的潜行电流干扰,而在这方面金属氧化物器件研究至关重要。
近日,南方科技大学深港微电子学院助理教授李毅达、林龙扬、周菲迟等课题组和南科大交叉研究院沈美研究助理教授和深圳江波龙电子股份有限公司合作完成,在金属氧化物半导体器件领域取得多项研究成果,包括源漏缺陷调控低温ALD ZnO 薄膜晶体管迁移率、HfO2钝化层改善ALD ZnO 薄膜晶体管稳定性以及基于氧化铪合金的高性能忆阻器(HfZrO、HfZnO RRAM)。相关成果分别发表在国际微电子期刊IEEE Electron Device Letters (EDL)和会议IEEE Electron Devices Technology and Manufacturing (EDTM) Conference、IEEE China Semiconductor Technology International Conference (CSTIC)和International Conference on Solid-State Devices and Materials (SSDM)。
高性能ALD ZnO 薄膜晶体管
氧化锌(ZnO)是一种经济、环保的金属氧化物半导体材料,在过去的几十年里被广泛应用于工业中。近年来,ZnO作为一种用于薄膜晶体管(TFT)的宽禁带半导体因其优异的电学性能而受到了广泛的研究。课题组作采用低温原子层沉积工艺制备了适用于后端工艺集成的低温ZnO薄膜晶体管。通过Ar等离子体调节源漏接触的缺陷密度,实现了具有高电子浓度的源漏接触设计,能够有效调节金属和半导体接触处的能带弯曲。通过XPS和AFM表征,阐明了等离子体处理前后ZnO半导体缺陷和表面粗糙度的变化。优化Ar等离子体处理时间后,晶体管接触电阻显著降低为84 Ω/μm,有效场效应迁移率提高了50%,达到39.2 cm2/Vs,是迄今为止使用ALD工艺在低温(200 ℃)下实现较高迁移率的报道之一。此外,课题组也报道了一种空气稳定,高迁移率的 ALD ZnO 薄膜晶体管,利用10 nm ALD HfO2钝化层的ZnO 薄膜晶体管在空气中的稳定性可以保持10天以上。(图一)。

图一:(左)ZnO晶体管制备工艺;(中)ZnO晶体管优化后的电学性能;(右)HfO2为钝化层的ZnO薄膜晶体管维持长时间稳定性,体现在转移曲线上
这一系列的工作对氧化物半导体-金属接触的研究提供了方案和机制理解,为进一步集成氧化物半导体忆阻器阵列的存算一体系统奠定了基础。相关成果以(1)“Field-Effect Mobility Enhancement in Low Temperature ALD ZnO Thin-film Transistors via Contact Defects Engineering Suitable for BEOL Integration”、(2)“Contact Resistance Reduction of Low Temperature Atomic Layer Deposition ZnO Thin Film Transistor Using Ar Plasma Surface Treatment”和(3)“Air Stable High Mobility ALD ZnO TFT with HfO2 Passivation Layer Suitable for CMOS-BEOL Integration”为题分别发表在IEEE Device Letter 期刊、IEEE Electron Devices Technology and Manufacturing (EDTM) 、和IEEE China Semiconductor Technology International Conference (CSTIC)会议上。(1)和(2)以南科大-哈工大联培博士生陆继清为第一作者,(3)以南科大深港微电子学院研究生王文辉为第一作者,南方科技大学为全部论文第一单位。
高性能合金氧化物(HZO、HfZnO)忆阻(RRAM)器用于超高密度嵌入式存储器
金属氧化物RRAM由于其结构简单、运行速度快、能耗低,被认为是最具可行性的下一代候选存储器。同时,RRAM低功耗和高速编程特性,以及LTP和LTD等突触特性,满足了神经形态计算架构的精确要求,表现出作为人工突触的巨大潜力。随着RRAM技术的不断发展,人们对RRAM的工作电压、速度和能量等性能寄予了更高的期望。课题组提出了以合金的方式,系统性地对RRAM工程设计,提升性能。在一个工作中,课题组利用一种ALD工艺沉积的锌合金HfO2 (HZnO)RRAM。与HfO2 RRAM相比,HZnO RRAM的Set电压显著降低(1.7 V/1 V),转变能量降低一个数量级至3pJ。此外,HZnO RRAM还表现出良好的LTP和LTD突触特性和可靠性(85℃,保持时间105s)(图二、三)。

图二: (左)HfO2 RRAM,(右)HZnO RRAM I-V曲线。
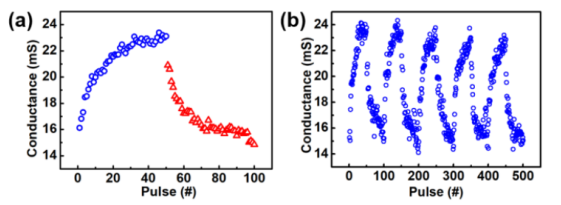
图三:(左)HZnO RRAM的LTP和LTD突触特性;(右)连续5个P/D周期的LTM特性。
在另一个工作中,课题组利用共溅射方法实现高性能HfO2和ZrO2合金化的Hf1-xZr1-xO2(HZO)RRAM。共溅射方法可以灵活方便调节材料的特性,如氧空位(Vo)和化学计量比。与HfO2和ZrO2 RRAM相比,HZO RRAM的工作电压降低了30%,这是由于Zr合金化增加了氧空位。同时,直流循环大于350次,保持时间超过104 s,快速转变时间降至10 ns,转变能量为20 pJ,以及具有良好的均一性(图四)。

图四:(左)四种不同化学计量比的RRAM 20次直流循环;(右)HZO RRAM交流脉冲转变
相关成果以(1)“Zinc-Alloyed Hfo2 Based Artificial Synaptic RRAM With Operating Voltages And Switching Energy Improvement For Ultra-High-Density Embedded Memory Applications” 和(2)“Hf1-xZrxO2 RRAM Prepared via Co-Sputtering with High Uniformity, Fast Switching Time of 10 ns, and Low Switching Energy of 20 pJ”为题发表在IEEE China Semiconductor Technology International Conference (CSTIC)和International Conference on Solid-State Devices and Materials (SSDM)会议上。(1)以南科大深港微电子学院研究生兰俊为第一作者,(2)以南科大深港微电子学院研究生朱泉舟为第一作者,南方科技大学为全部论文第一单位。
以上研究工作得到了国家自然科学基金、深圳市基础研究项目的资助,广东省三维集成工程技术研究中心、南科大分析测试中心的支持。
论文链接:
1. https://ieeexplore.ieee.org/document/9761217
2. https://ieeexplore.ieee.org/abstract/document/9798319/
3. https://ieeexplore.ieee.org/document/9856860
4. https://ieeexplore.ieee.org/document/9856852
5. https://confit.atlas.jp/guide/event/ssdm2022/subject/F-2-04/advanced